無電解UBMめっき加工
サービス
概要
半導体パッケージング技術の小型化、高集積化に伴ない、LSIやICなどのチップの接合方法としてワイヤボンディング法からフリップチップ法への移行が広がっており、フリップチップ法においては金属パッドとはんだの接合を目的としたUBMの形成が必須とされています。
当社のUBM加工は無電解めっき処理にて行っており、低コスト化、短納期化、小型化を実現、更には環境にも配慮した技術となっております。
用途例
- UBMとは?
- UBM (Under Bump Metallurgy) は、半導体電極上に形成する金属膜で、はんだやワイヤボンディング接合信頼性を向上させます。
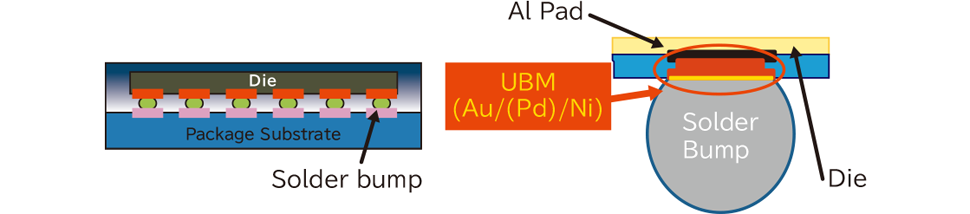
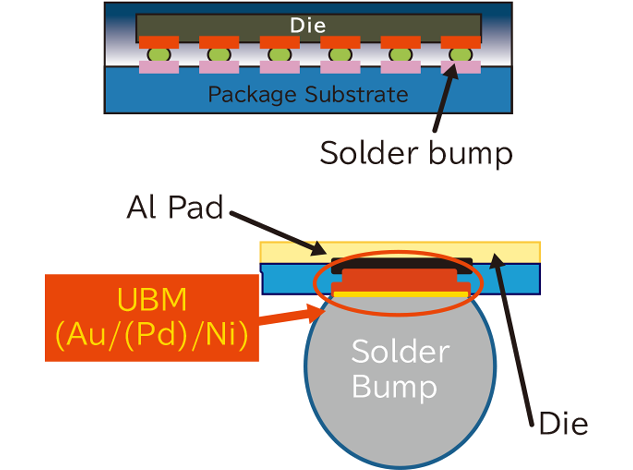
ご採用のメリット
- 当社プロセスにより、お客様の種々のニーズに対応します。
- ・10μm径以下の小口径パッドから1cm径以上の大口径パッドまで、幅広いサイズのパッドに良好な外観・安定した膜厚のめっき処理が可能です。
- ・ウェハ表裏面同時めっき処理が可能です。
- ・薄ウェハ、TAI KOウェハへのめっき処理が可能です。
- ・12inchウェハにも安定しためっき処理が可能です。
- 充実した分析・評価設備を保有し、迅速にめっき皮膜を分析・解析することが可能です。
標準仕様
| ウェハ材質 | Si、GaAs、SiC、GaN |
| ウェハサイズ | 50〜300mmφ(2〜12inch wafer) |
| パッド材質 | Al、AlSi、AlCu、AlSiCu、Cu、Au |
| UBM | E-less Ni/Au、E-less Ni/Pd/Au (Pb and Cyanide-free plating sln.) |
| Ni中のP品位 | 5〜10% |
| Ni厚み | 1〜5μm |
| Pd厚み | 0.05〜0.2μm |
| Au厚み | Ni/Au:0.05〜0.2μm Ni/Pd/Au:0.02〜0.1μm |
| 厚み均一性 | ±10%(8inch wafer) |
分析機器の例


よくある質問
12インチウェハへのUBM加工
-
対応可能となります
TAIKOウェハへのUBM加工
-
対応可能となります
当社の採用メリット
-
幅広いサイズと種類のパッドに良好な外観・安定した膜厚のめっき処理が可能(Ni/Pd/AuおよびNi/Au)


